激光重熔釬料凸點的思想是從激光軟釬焊發展而來的。激光軟釬焊方法能夠在很短的時間內使被連接處形成一個能量密度高度集中的局部加熱區,封裝器件不會產生熱應力,熱敏感性強的器件不會受熱沖擊。同時還能細化焊點的結晶晶粒度從而也提高了焊點的韌性與抗疲勞性能。自從1974 年美國的C. F. Bohman 率先將CO2 激光應用于微電子組裝軟釬焊以來,激光軟釬焊設備和工藝得到了迅速的發展,并且在QFP 器件的表面組裝中得到了應用。伴隨著面陣列電子封裝器件的出現和應用,人們開始將激光軟釬焊的思想用在了陣列式封裝釬料凸點成形或連接工藝中。
1996 年德國Fraunhofer IZM 與柏林Pac Tech 公司合作開發了無釬劑釬料凸點成型機。該機器包括一個Z 軸可控的分球裝置頭、用于重熔的激光束與用于基板定位的可精確控制的X - Y 工作臺。該設備在工作時分球裝置首先把釬料球導入吸嘴,然后用N2 氣將球吹到芯片焊盤上,短脈沖激光迅速對釬料球進行重熔。由于采用N2 氣保護,因此獲得的釬料凸點成形良好。該設備可以在芯片和基板上制作尺寸從FC(100μm) 至BGA(1 mm) 的釬料凸點,而且可以放置間距為150μm 的釬料球。既適合于PbSn釬料,也適合于高熔點無鉛釬料如AuSn。激光無釬劑釬料凸點成形機如圖1 所示。
在激光重熔光源的選擇研究方面,Nd : YAG激光、半導體激光均被人們所采用。一般研究表明,采用YAG激光進行重熔要優于CO2 激光,因為PCB 材料對波長為10. 6μm 的CO2 激光的吸收率遠大于波長為1. 06μm 的YAG激光,而未熔化釬料對CO2 激光的反射率也大于YAG激光,因此在保證加熱效率的同時可有效防止凸點激光反射對基板的損傷,而且YAG激光可利用光導纖維傳輸激光能量。半導體激光的波長更短(780~830 nm) ,輻射能量更易被釬料吸收;同時半導體激光器的電—光轉換效率可達30 % ,而CO2 激光器只有10 % ,YAG激光器僅有1 %~3 %;此外半導體激光器結構極為緊湊,維護簡單,這些特點使半導體激光器在自動化
的激光重熔系統中表現出巨大的吸引力,并將成為今后主要發展方向。目前典型的半導體激光二極管陣列的輸出功率已達20~50 W。圖2 為松下公司研制的具有視覺系統的激光二極管陣列重熔系統。該系統的核心是激光二極管陣列光源,通過光纖束傳遞激光,并利用絕緣鏡校直激光與待重熔部位對準。
1999 年柏林工業大學Fraunhofer 學院與PacTech GmbH 公司合作開發了激光光纖推進連接(FPC) 方法,實現了芯片級尺寸封裝的載帶與芯片共晶Au - Sn 釬料凸點之間的連接。如圖3 所示,該方法通過噴嘴推進在載帶后方施加完成連接所需要的連接力,同時采用高度穩定的玻璃光纖傳遞Nd :YAG激光并加熱待連接部位,Au - Sn 釬料熔化完成芯片凸點與載帶之間的連接。
總之,近年來國外對激光重熔方法及設備的研究是相當活躍的,隨著機器人技術、光電子技術的發展,激光器類型不斷更新,其自動化程度及激光可控調制特性都在提高,應用領域也在逐步拓展。激光重熔將在面陣列封裝器件釬料凸點成形方面發揮越來越重要的作用。
轉載請注明出處。







 相關文章
相關文章
 熱門資訊
熱門資訊
 精彩導讀
精彩導讀




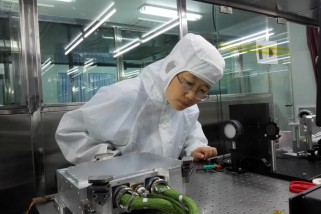






















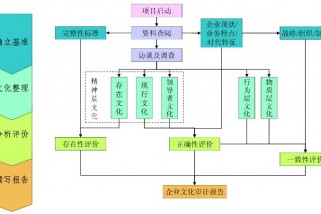





 關注我們
關注我們




