MEMS封裝技術正迅速朝標準化邁進。為滿足移動裝置、消費性電子對成本的要求,MEMS組件廠商已開始舍棄過往客制化的封裝設計方式,積極與晶圓廠、封裝廠和基板供貨商合作,發展標準封裝技術與方案,讓MEMS組件封裝的垂直分工生態系統更趨成熟。
隨著智能型手機或其它消費性電子裝置大舉導入微機電系統(MEMS)傳感器,MEMS封裝產值已顯著增長,在未來幾年內市場規模將達到整體IC產業的5%,比重大幅攀升。由于大量消費應用的快速成長和逐漸集中在某些裝置,將導致MEMS封裝技術成為市場決勝關鍵,相關廠商必須投入發展標準封裝方案,方能持續壓低組件尺寸及量產成本。
MEMS出貨需求激增 半導體封裝廠迎新商機
MEMS封裝產業的規模在2012年已達16億美元,總共出貨七十多億顆芯片,且市場需求正快速增加,2010~2016年整個MEMS封裝產值的年復合成長率(CAGR)將達到20%,至2016年出貨量將上看一百四十億顆。不過,低成本消費性電子產品逐漸主導MEMS市場,也為相關廠商帶來價格壓力,將使營收的CAGR僅有10%,至2016年將達到26億美元(圖1)。
無論哪一種計算方式,MEMS封裝市場的成長率仍比主流IC封裝多出約一倍的幅度,雖然MEMS包含各式各樣的產品,組件特性與封裝需求也天差地別,但近來MEMS市場已逐漸被特定裝置主導,如消費性應用目前占整體MEMS營收50%以上,四大主要裝置包括加速度計、陀螺儀、磁力計和麥克風,出貨占比已超過所有MEMS出貨量的一半。

圖1 2010~2016年MEMS封裝產值成長預測
因應消費性電子的大量需求,未來MEMS封裝技術將朝標準化演進,為產業帶來許多改變的空間。盡管目前封測代工廠至今只占40%的MEMS封裝業務(以金額計),而整合組件制造商(IDM)則主導大半市場,后者依靠專業封裝技術達成產品區隔;但是,隨著MEMS在消費性應用領域的出貨量遽增,將驅動更多制造商外包封裝及裝配業務,建立垂直分工的供應鏈,為半導體封測廠引來更多商機。
價格在這些消費市場當然也很重要,而制造商藉由不斷減少芯片大小,已大幅降低制造成本。現階段,消費性應用的MEMS封裝尺寸大多為2毫米(mm)×2毫米,高度上限則為1毫米,且還會持續縮小。以應用廣泛的MEMS加速度計為例,由于封裝占制造成本約35~45%,促使業界揚棄對每個裝置做客制化封裝服務,而迎向更標準的封裝類別,因此在類似裝置上大多可重復使用,加速新世代的發展。
另一方面,移動裝置或消費性電子的成本及功能設計需求,也驅動慣性傳感器由分離式封裝轉向多芯片整合模塊。主要原因系系統廠要求能有效管理傳感器數據,以減少感測誤差,因此MEMS供貨商須提供更短、更快的各種MEMS組件連接方案。
這些新興組合組件未來將是慣性傳感器市場主要成長動力,因而產生新的封裝、裝配及測試需求,如模塊須以高良率的裸晶裝配才能符合經濟效益,而測試及交叉校正則須提高至六個、九個或十個傳感器所有標軸;至于制造商更須要想出保障這些復雜多重零組件系統的方式。
強攻3D WLP封裝 MEMS廠商花招百出
絕大多數MEMS裝置(約總數的75%)為封裝中的打線接合系統(Wire-bonded System),然后是Side by Side接合方案,或是和控制用的特定應用集成電路(ASIC)堆棧在標準導線架、球門陣列(BGA)/平面柵格數組(LGA)壓合基板。長期而言,前兩項方式仍會是主要封裝技術,但約有兩成MEMS組件將直接與基于互補式金屬氧化物半導體(CMOS)的ASIC整合成系統單芯片(SoC)。
業界一度以為大部分MEMS都將采用SoC方式,但目前此類組件只適用在須非常短距離連結的特殊裝置,如每個畫素單位都要有直接反應的MEMS微透鏡(Micromirror)、熱像傳感器(Microbolometer)或振蕩器。大多數MEMS系統在封裝層級,連結不同的零組件上最有效率,但對更小的裝置及以更短距離相互連接的需求,正轉移至MEMS、ASIC和主機板間的接合、晶圓凸塊連結或3D堆棧架構。
目前許多MEMS制造商具備獨特的晶圓堆棧方案,并已導入生產慣性傳感器,包括晶圓凸塊到金屬對金屬接合、MEMS內硅晶、多晶硅填充導孔到中介層導孔等方式;然而,在MEMS制造技術的競爭逐漸轉向功能性競爭的情況下,將有更多廠商采納標準封裝方案,以拉低成本并加快開發時程。
舉例來說,無晶圓廠的應美盛(InvenSense)即與臺積電、格羅方德(GLOBALFOUNDRIES)等晶圓代工廠合作,以高效率、低成本的鋁鍺共晶金屬對金屬接合覆蓋制作方法,將MEMS與ASIC結合,在消費性陀螺儀市場大有斬獲。值得注意的是,該公司目前公開授權此相互連結技術,透過與其它晶圓廠認證制程,與多項目晶圓(Multi Project Wafer)結合,相較獨立研發而言,可發展出更多應用與技術。
目前兩家主要MEMS晶圓代工廠商都將目標放在客戶尋求的硅穿孔(TSV)平臺上,以滿足MEMS廠商對小尺寸封裝的殷切需求。Silex Microsystems長期以來提供TSV模塊給客戶,而Teledyne DALSA為MEMS晶圓廠客戶,也在晶圓層級MEMS連結ASIC方面,開發低成本Wet-plated Copper TSV平臺。Teledyne DALSA使用授權的Alchimer電鍍制程技術,在同一個制程模塊整合導孔隔離(Via Isolation)及填充,以達到更佳的成本效率,并與該公司合作開發量產。
意法半導體(ST)則以更獨特的方式,自行在MEMS芯片上制造TSV,并將芯片附著在主機板上。此方法藉由蝕刻空氣間隙,消除接合焊盤所需的空間,以隔離的多晶硅導孔取代,雖用基本MEMS制程,但必須在大約十倍的尺寸上進行,才能以打線接合或覆晶方式附著于ASIC。如此一來,芯片尺寸可較溫和增加成本的TSV制程減少20~30%,總成本較低。該公司目前以此技術量產加速度計,并表示接下來將導入陀螺儀,甚至用于更小的多芯片模塊。
同時,Bosch Sensortec及Murata/VTI也運用自己的技術,但封裝基礎架構則利用外包形式。Bosch Sensortec采取相對傳統的焊接凸塊方式連接MEMS和ASIC。Murata以硅晶中介層、蝕刻導孔周圍的矩陣覆蓋MEMS慣性傳感器,并以硼硅玻璃填充,然后覆晶于打薄的ASIC#p#分頁標題#e#上,在其四周加上較大的焊接球,將整層裝上主機板。
至于中介層部分則可由其MEMS晶圓廠或工程基板供貨商如PlanOptik制造,凸塊則由ASIC供應廠或凸塊轉包商負責,而最后可能在馬來西亞的Unisem將芯片接合到晶圓、進行裝球及底部填充。
顯而易見,MEMS標準封裝技術,以及垂直分工的生態系統正快速崛起,將為往后的MEMS產業帶來全新的樣貌。
轉載請注明出處。







 相關文章
相關文章
 熱門資訊
熱門資訊
 精彩導讀
精彩導讀




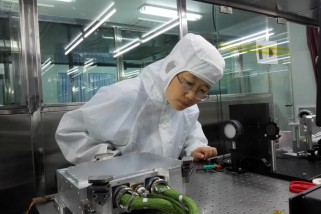






















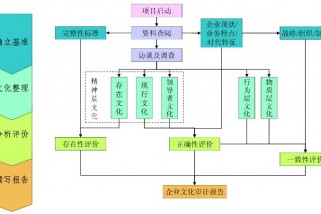





 關注我們
關注我們




