GaAs上VCSEL
基于GaAs基材料系統的VCSEL由于高的Q值而備受研究者青睞,目前VCSEL最多也是生長在GaAs襯底上。但以GaAsSb QW作為有源區的CW長波長VCSEL發射波長被限制在1.23 m。發射波長1.3 m的GaAsSb-GaAs系統只有側面發射激光器中報道過。日前美國貝爾實驗室的F.Quochi等人演示了室溫CW時激射波長為~1.28 m的生長在GaAs襯底下的光泵浦GaAsSb-GaAs QW VCSEL。這個波長是目前報道的GaAsSb-GaAs材料系最長的輸出波長。
(3)新工藝
氧化物限制工藝
氧化物限制的重大意義在于:能較高水平地控制發射區面積和芯片尺寸,并能極大地提高效率和使光束穩定地耦合進單模和多模光纖。因此,采用氧化物限制方案器件有望將閾值電流降到幾百A,而驅動電流達到幾個mA就足以產生1mW左右的輸出光功率。
采用氧化孔徑來限制電流與光場,使效率得到顯著提高,同時降低了VCSEL的閾值電流。所以,現在極有可能在單個芯片上制作大型和密集型封裝的氧化限制VCSEL陣列而不會存在嚴重的過熱問題。除低閾值電流和高效率外,均勻性是成功的VCSEL陣列的又一重要因素。在駐波節點處設置微氧化孔提高了VCSEL陣列的均勻性,并降低了小孔器件的散射損耗。美國University of Southern California大學日前演示的均勻晶片鍵合氧化限制底部發射850nm VCSEL陣列中,5 5 VCSEL陣列的平均閾值電流低至346 A,而平均外量子效率接近57%,室溫連續波電流激射時單模輸出功率超過2 mW。他們還演示了大(10 20)VCSEL陣列,其閾值電流和外量子效率的變化分別低于4%與2%。
晶片鍵合工藝
長波長垂直腔面發射激光器(LW-VCSEL)因其低價格、超低閾值和小的光束發散,作為光纖通信系統中的激光源有很大的潛力。但是由于它的氧化層和有源層間存在著為滿足足夠的電流傳播和弱的光橫向限制的固有距離,使LW-VCSEL遭受橫電光限制,因此在高的結電流時會出現一個不穩定的橫模圖形。
日本NTT光子實驗室將具有充分的橫向限制的掩埋異質結(BH)引入1.55 m VCSEL中,采用了薄膜晶片鍵合工藝使InP基掩埋異質結VCSEL制作在 GaAs-DBR 上。具體過程:(a)采用MOCVD生長InP 基激光器結構(第一次生長);(b)采用反應離子刻蝕(RIE)形成臺面方形;(c)再一次生長摻Fe InP層和n-InP層(第二次生長);(d)又一次生長p-InP相位匹配和p-InGaAs接觸層(第三次生長);(e)將外延層安裝在Si板上并用蠟作機械支撐;(f)采用HCl和H3PO4化學溶液腐蝕InP襯底和InGaAsP腐蝕中止層;(g)將InP基和GaAs基層的兩表面在相同結晶方向面對面放置,然后在室溫下蠟熔解而使Si片分開,將樣品送入退火爐以形成化學鍵合;(h)將臺面上部的p-InGaAs移開并將普通電極和SiO2-TiO2介質鏡從臺面上移去。底部涂覆一層抗反射涂層。
因為熔合界面遠離有源區,而且它不在器件電流通過的路徑上,所以晶片鍵合過程不會影響器件特性。
此LW-VCSEL結構有以下優點:首先,諧振腔波長可在晶片融合之前監控,因此發射波長可以提前控制。第二,激光器工作的可靠性會由于有源層和InP-GaAs熔合界面之間有足夠距離而變得很高。此外,它能低電壓工作的潛力在很大程度上是因為p-GaAs-AlAs DBR和p-InP-p-GaAs界面間的高電阻得到了消除。
轉載請注明出處。







 相關文章
相關文章
 熱門資訊
熱門資訊
 精彩導讀
精彩導讀




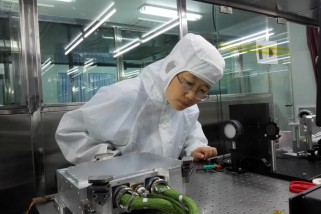






















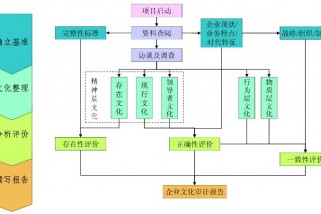





 關注我們
關注我們




