8月21日,從江蘇通用半導體有限公司傳來消息,由該公司自主研發的國內首套的8英寸碳化硅晶錠激光全自動剝離設備正式交付碳化硅襯底生產領域頭部企業廣州南砂晶圓半導體技術有限公司,并投入生產。

圖:8英寸SiC晶錠激光全自動剝離設備
該設備可實現6英寸和8英寸碳化硅晶錠的全自動分片,包含晶錠上料、晶錠研磨、激光切割、晶片分離和晶片收集,一舉填補了國內碳化硅晶錠激光剝離設備領域研發、制造的市場空白,突破了國外的技術封鎖,將極大地提升我國碳化硅芯片產業的自主化、產業化水平。
該設備年可剝離碳化硅襯底20000片,實現良率95%以上,與傳統的線切割工藝相比,大幅降低了產品損耗,而設備售價僅僅是國外同類產品的1/3。
近年來,碳化硅功率器件在大功率半導體市場中所占的份額不斷提高,并被廣泛應用于新能源汽車、城市軌道交通、風力發電、高速移動、物聯網等一系列領域。
但是,由于材料的高硬度、高脆性的特點,在使用傳統的砂漿線、金剛石線等冷切工藝切割、剝離碳化硅晶錠時,存在效率過低、損耗過高的缺點,導致襯底產能提升過慢,遠遠不能滿足市場的實際需求。由于產能嚴重不足,碳化硅襯底的生產成本一直居高不下,在器件成本構成中,碳化硅器件中襯底要占成本的47%,遠遠高于硅基器件的7%。
江蘇通用半導體有限公司董事長陶為銀介紹, 采用基于激光工具和加工技術切割、剝離碳化硅晶錠,可實現高效、精確和高質量的制造,極大地降低碳化硅襯底的生產成本,減少浪費和環境影響。
碳化硅器件屬于寬禁帶半導體,不但在民用領域應用廣泛,在國防領域也普遍應用。因此對相關技術,西方發達國家都實行出口管制。目前,只有一家日本企業生產制造碳化硅晶錠激光剝離設備,售價高達一億元,且對中國實施禁售。

江蘇通用半導體有限公司成立于2019年,致力于高端半導體產業裝備與材料的研發和制造,于2020年推出國內首臺半導體激光隱形切割機;2022年成功推出國內首臺18納米及以下SDBG激光隱切設備(針對3D Memory);2024年研制成功SDTT激光隱切設備(針對3D HBM)。
轉載請注明出處。









 相關文章
相關文章
 熱門資訊
熱門資訊
 精彩導讀
精彩導讀






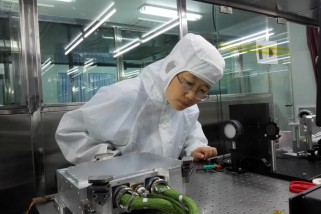

















 關注我們
關注我們




