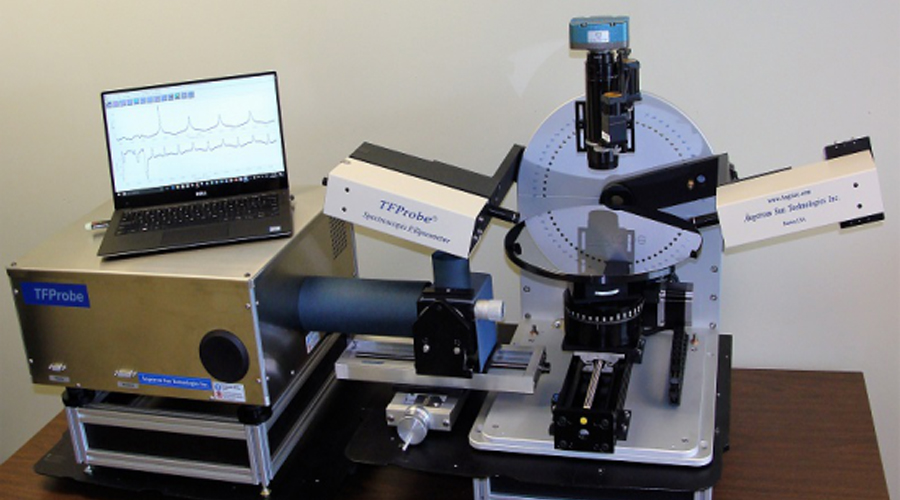
紅外光譜橢偏儀
一、在半導體工藝中,摻雜雜質類型、濃度及結深的改變都會引起不同頻率的紅外光譜,介紹了一種通過紅外橢偏儀測量淺結雜質分布的方法:利用 Drude 方程將 Si 中不同摻雜與其引起的光學常量的變化對應起來,通過紅外橢偏分量 Ψ 和 Δ 的測量及模型擬合來測定半導體中載流子的濃度分布。并建立高斯漸變層模型,即將離子注入退火后的非均勻摻雜層分成 n 小層,各層載流子濃度之間符合高斯分布,且每一層載流子濃度可以用 Drude 方程來描述。測量采用了可變角度的紅外光譜橢偏儀,該測量方法具有非接觸性、非破壞性的優點,測量快捷方便。
本文介紹一種利用紅外橢偏光譜儀測量半導體中載流子濃度的方法。利用紅外橢偏儀測量 Si 中離子注入退火后的雜質濃度分布,具有測量精度高﹑非損傷性以及能區分不同物理效應等優點。摻雜半導體的光學吸收系數和折射率與其中自由電子或空穴濃度有關。從原理上說,可以借助測量吸收系數或反射率來確定半導體中載流子濃度。同時半導體雜質注入退火后的載流子分布近似服從高斯分布,紅外橢偏儀正是基于以上兩點完成測量、模型建立及數據擬合,從而確定雜質濃度分布的。利用這種光學方法的優點在于非接觸和非破壞性的,適用于淺結雜質分布的測量。
紅外橢偏儀的測量原理與普通的光譜橢偏儀一樣,也是測量橢偏參量 ψ 和 Δ。不同的是普通橢偏儀的光譜范圍為 0. 37 ~ 1 μm,通常用來測量介質層、聚合物等薄膜厚度及光學常數。紅外橢偏儀的光譜范圍為 2 ~ 30 μm,在這一光譜范圍內,半導體的光學吸收系數和折射率與其中自由電子或空穴濃度有關。可以借助于測量吸收系數或反射率來確定半導體中載流子濃度。
二、模型的建立
注入退火后載流子分布與 SiO2 和 SiN 等固定介電常數介質膜不同。注入退火后載流子分布是非均勻分布,其介電常數隨結深的不同而變化,因此可以建立一個漸變層模型,即將整個摻雜層分為 n層,n 取值足夠大時,即可假定在每一小層內有固定的介電常數。每一層的光學特性可以用經典Drude 模型來描述,該模型是將半導體的電特性和光學特性相對應的一種模型。本次測量建立了兩個模型: ①在 n 型襯底注入p 型雜質并退火的模型; ②在 p 型稱底注入 n 型雜質并退火的模型。橢偏測量模型先通過 Drude 模型定義各層摻雜濃度,再通過高斯分布將測得的各層雜質原子分數聯系起來得到一個連貫的濃度分布圖。

三、結論
通過紅外光譜橢偏儀對摻雜半導體進行橢偏數據測量,又通過 Drude 漸變層模型對測量數據進行擬合,從而得到載流子的雜質分布圖。從雜質分布圖可以得到峰值濃度雜質的、結深等摻雜層信息。
紅外橢偏測量具有非接觸性、非破壞性的優點,測量快捷方便,可作為半導體制造工藝中在線監控雜質分布、結深的有效手段。尤其能夠對淺結雜質分布進行測量。缺點是摻雜濃度低時,通常是低于 10 18 cm-3 ,雜質在紅外波段引起的折射率及介電常數變化不靈敏,因此測量精確度不太高。
轉載請注明出處。









 相關文章
相關文章
 熱門資訊
熱門資訊
 精彩導讀
精彩導讀






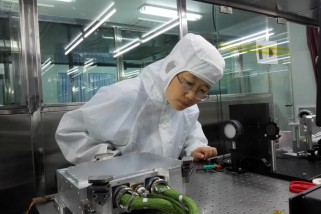

















 關注我們
關注我們




